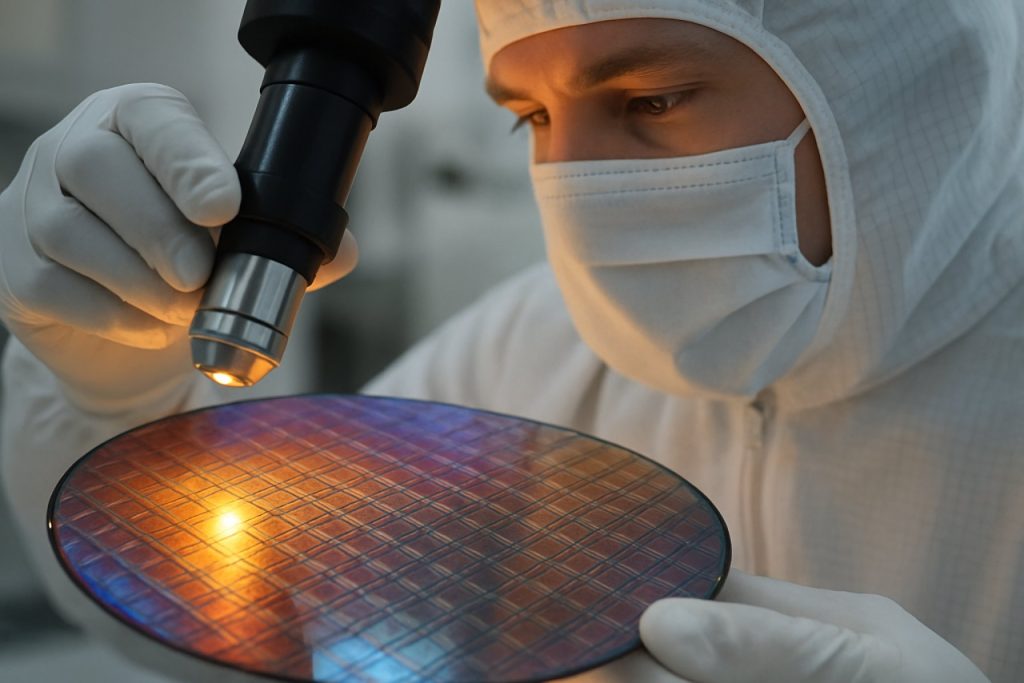
Усередині світу метрології напівпровідників: як точне вимірювання формує майбутнє мікроелектроніки. Відкрийте для себе технології та інновації, які забезпечують безпрецедентну продуктивність мікросхем.
- Вступ до метрології напівпровідників
- Роль метрології у виробництві напівпровідників
- Ключові методи та інструменти вимірювання
- Виклики в наномасштабному вимірюванні та інспекції
- Останні інновації та нові технології
- Вплив на вихід, якість і продуктивність пристроїв
- Метрологія для новітніх вузлів: 3 нм і далі
- ШІ та автоматизація в метрології напівпровідників
- Тенденції ринку та провідні учасники галузі
- Перспективи: масштабування, інтеграція та нові матеріали
- Джерела та посилання
Вступ до метрології напівпровідників
Метрологія напівпровідників є критично важливою дисципліною в індустрії виробництва напівпровідників, яка охоплює вимірювання, характеристику та аналіз матеріалів, структур і пристроїв на мікро- та наномасштабі. Оскільки геометрії пристроїв продовжують зменшуватися, а складність процесів зростає, точна метрологія стає незамінною для забезпечення якості продукції, виходу та продуктивності. Ця галузь інтегрує різноманітні фізичні, хімічні та електричні методи вимірювання для моніторингу та контролю процесів виготовлення, від підготовки ваферів до остаточної інспекції пристроїв.
Сучасна метрологія напівпровідників вирішує такі проблеми, як виявлення субнанометрових дефектів, точне вимірювання товщини тонких плівок, контроль критичних розмірів (КР) та точність накладення. Ці вимірювання є життєво важливими для оптимізації процесів та досягнення суворих специфікацій, що вимогуються для новітніх технологічних вузлів. Методи, такі як скануюча електронна мікроскопія (СЕМ), атомно-силова мікроскопія (АСМ), еліпсометрія та рентгенівська дифракція, регулярно використовуються для надання високороздільного, неруйнівного аналізу матеріалів та структур напівпровідників.
Важливість метрології підкреслюється її роллю у забезпеченні контролю процесів та підвищенні виходу, що безпосередньо впливає на економічну доцільність і надійність напівпровідникових пристроїв. Оскільки індустрія переходить до все менших вузлів та інтегрує нові матеріали та архітектури, попит на інноваційні метрологічні рішення продовжує зростати. Галузеві організації та дослідницькі установи, такі як SEMI та Національний інститут стандартів і технологій (NIST), відіграють ключову роль у розробці стандартів та просуванні метрологічних технологій для підтримки еволюціонуючих потреб виробництва напівпровідників.
Роль метрології у виробництві напівпровідників
Метрологія відіграє важливу роль у виробництві напівпровідників, служачи основою для контролю процесів, покращення виходу та надійності пристроїв. Оскільки геометрії пристроїв зменшуються до нанометрового масштабу, вимоги до точних та акуратних методів вимірювання посилюються. Метрологія дозволяє виробникам контролювати критичні розміри (КР), товщину плівок, концентрацію домішок та густину дефектів на кожному етапі процесу виготовлення. Цей зворотний зв’язок в режимі реального часу є необхідним для підтримання однорідності процесу та виявлення відхилень, перш ніж вони вплинуть на продуктивність пристроїв або вихід.
Сучасні метрологічні інструменти, такі як скануючі електронні мікроскопи (СЕМ), атомно-силові мікроскопи (АСМ) та оптичні розсіювання, інтегруються в виробничі лінії для надання неруйнівних, високопродуктивних вимірювань. Ці інструменти підтримують швидке виявлення відхилень процесу та впровадження коригувальних дій, тим самим зменшуючи витрати на переробку та відходи. Крім того, дані метрології все частіше використовуються у поєднанні з алгоритмами машинного навчання для забезпечення прогностичного контролю процесів та ініціатив безперервного покращення.
Складність сучасних напівпровідникових пристроїв, включаючи 3D-архітектури та гетерогенну інтеграцію, сприяє розвитку метрологічних методик. Внутрішня метрологія тепер виходить за межі традиційних параметрів і включає вимірювання точності накладення, шорсткості країв ліній та складу матеріалів на атомному рівні. Інтеграція метрології з системами просунутого контролю процесу (АПК) є критично важливою для досягнення суворих специфікацій, необхідних для технологій наступного покоління.
Таким чином, роль метрології у виробництві напівпровідників полягає не лише в забезпеченні відповідності дизайну специфікаціям, але й у сприянні інноваціям і масштабуванню в індустрії, визначеній швидкими технологічними змінами та жорсткою конкуренцією. Для отримання додаткової інформації дивіться Національний інститут стандартів і технологій та SEMI.
Ключові методи та інструменти вимірювання
Метрологія напівпровідників покладається на набір розширених методів і інструментів вимірювання для забезпечення точності та надійності, необхідних у сучасному виготовленні пристроїв. Серед найважливіших методів є скануюча електронна мікроскопія (СЕМ), яка забезпечує зображення високої роздільної здатності для вимірювання критичних розмірів (КР), що дозволяє моніторити розміри функцій на нанометровому масштабі. Атомно-силова мікроскопія (АСМ) є ще одним важливим інструментом, який пропонує тривимірне профілювання поверхні з субнанометровою вертикальною роздільною здатністю, що є критично важливим для характеристики шорсткості поверхні та висоти сходинок.
Для аналізу тонких плівок еліспометрія широко використовується для визначення товщини плівки та оптичних властивостей без руйнації. Рентгенівська фотоелектронна спектроскопія (XPS) і мас-спектрометрія вторинних іонів (SIMS) використовуються для композиційного та хімічного аналізу, забезпечуючи профілювання глибини та ідентифікацію елементів. Чотирьохточкові зразки є стандартом для оцінки питомої провідності в провідних шарах, тоді як профілювання ємність-напруга (C-V) використовується для оцінки концентрації та розподілу домішок у напівпровідникових джункціях.
Метрологічні інструменти все частіше інтегруються з автоматизованими системами інспекції ваферів для виявлення дефектів та моніторингу однорідності процесу по всій поверхні ваферів. Тенденція до зменшення вузлів та 3D-архітектур спонукала розвиток розсіювання та передавальної електронної мікроскопії (TEM) для неруйнівного та атомарного аналізу відповідно. Ці методи є незамінними для контролю процесів, підвищення виходу та відповідності галузевим стандартам, як зазначено такими організаціями, як SEMI і Національний інститут стандартів і технологій (NIST).
Виклики в наномасштабному вимірюванні та інспекції
Оскільки пристрої напівпровідникової техніки продовжують зменшуватись до нанометрового масштабу, виклики, пов’язані з наномасштабним вимірюванням та інспекцією, стають дедалі складнішими. Однією з основних труднощів є досягнення просторової роздільної здатності, необхідної для точної характеристики особливостей, які часто менші за довжину хвилі видимого світла. Традиційні оптичні метрологічні методи, такі як розсіювання та еліпсометрія, стикаються з фундаментальними обмеженнями через дифракцію, що вимагає впровадження передових методів, таких як скануюча електронна мікроскопія критичних розмірів (CD-SEM) та атомно-силова мікроскопія (АСМ). Однак ці методи несуть у собі власні виклики, включаючи ймовірні пошкодження зразків, низьку продуктивність та необхідність в складних алгоритмах інтерпретації даних.
Ще одним значним викликом є виявлення та класифікація дефектів на атомному чи близькому до атомного масштабі. Оскільки архітектура пристроїв стає більш складною, включаючи 3D-структури, такі як FinFET та транзистори з повним обертом (gate-all-around) – типи дефектів множаться, і їх стає важче ідентифікувати. Чутливість і специфічність, які вимагаються для інспекції дефектів, виходять за межі можливостей сучасних метрологічних інструментів, часто вимагаючи поєднання кількох методів та просунутого машинного навчання для аналізу даних. Крім того, інтеграція нових матеріалів, таких як діелектрики з високою проникністю та нові матеріали каналів, вводить додаткові змінні, які ускладнюють точність і повторюваність вимірювань.
Галузь також стикається з необхідністю в лінійних, високопродуктивних метрологічних рішеннях, які можуть конкурувати з розвиненими процесами виробництва без компромісів у точності. Це стимулювало значні зусилля в дослідженнях та розробках, як підкреслюють такі організації, як SEMI та Національний інститут стандартів і технологій (NIST), для розробки наступного покоління метрологічних інструментів та стандартів, що вирішують ці проблеми в наномасштабі.
Останні інновації та нові технології
Останні роки стали свідками значних досягнень у метрології напівпровідників, зумовлених безперервним зменшенням елементів пристроїв та інтеграцією складних 3D-структур. Однією з найбільш помітних інновацій є впровадження гібридної метрології, яка поєднує дані з кількох вимірювальних технік – таких як оптичне розсіювання, рентгенівська фотоелектронна спектроскопія та атомно-силова мікроскопія – щоб забезпечити більш комплексну та точну характеристику наномасштабних структур. Цей підхід вирішує обмеження індивідуальних методів та підвищує контроль процесу на сучасних виробничих вузлах Національний інститут стандартів і технологій.
Ще однією новою технологією є використання машинного навчання та штучного інтелекту (ШІ) для аналізу метрологічних даних. Алгоритми на основі ШІ можуть швидко обробляти величезні набори даних, виявляти тонкі варіації процесу та прогнозувати продуктивність пристроїв, що дозволяє забезпечувати зворотний зв’язок у реальному часі та адаптивну оптимізацію процесів. Це особливо цінно у середовищах масового виробництва, де швидкість і точність є критичними SEMI.
Крім того, вдосконалення електронної мікроскопії, такі як розробка скануючих електронних мікроскопів з низькою напругою (СЕМ) та транзисторів з покращеною роздільною здатністю, дозволили провести неушкоджене, високопродуктивне зображення все менших елементів. Внутрішні метрологічні інструменти також розвиваються, отримуючи нові можливості для вимірювання накладення, критичних розмірів та товщини плівки в складних 3D-структурах, таких як FinFET та транзистори з повним обертом (gate-all-around) ASML.
В цілому, ці інновації є важливими для підтримки подальшого масштабування пристроїв напівпровідників та забезпечення надійності та виходу інтегрованих схем наступного покоління.
Вплив на вихід, якість і продуктивність пристроїв
Метрологія напівпровідників відіграє важливу роль у визначенні виходу, якості та продуктивності пристроїв. Як тільки геометрії пристроїв зменшуються і складність збільшується, точне вимірювання та контроль критичних параметрів – таких як ширина ліній, товщина плівки та концентрація домішок – стають необхідними. Точна метрологія дозволяє рано виявляти відхилення процесу, що дозволяє вчасно вжити коригувальних заходів, які безпосередньо покращують вихід виробництва. Наприклад, сучасні метрологічні інструменти можуть виявляти субнанометрові варіації в критичних розмірах, які, якщо їх не контролювати, можуть призвести до збоїв в роботі пристроїв або зниження продуктивності Національний інститут стандартів і технологій (NIST).
Контроль якості у виготовленні напівпровідників сильно залежить від метрології. Внутрішні та офлайн метрологічні техніки, такі як скануюча електронна мікроскопія (СЕМ), атомно-силова мікроскопія (АСМ) та еліпсометрія, забезпечують зворотний зв’язок в реальному часі про однорідність процесу та густину дефектів. Цей зворотний зв’язок є критичним для підтримки високої якості продукту та мінімізації витрат на переробку або відходи. Крім того, оскільки пристрої переходять у суб-5 нм режим, метрологія повинна вирішувати нові проблеми, такі як характеристика 3D-структур і аналіз складу матеріалів, які є критично важливими для забезпечення надійності та довговічності пристроїв Ассоціація напівпровідникової промисловості.
В кінцевому підсумку, міцна метрологія становить основу продуктивності пристроїв напівпровідників, забезпечуючи, що кожен етап процесу відповідає суворим специфікаціям. Це не лише підвищує швидкість та енергетичну ефективність пристроїв, але й підтримує швидкі цикли інновацій, яких вимагає електронна індустрія. Як наслідок, інвестиції в просунуті метрологічні рішення є ключовим чинником конкурентоспроможності у виробництві напівпровідників ASML.
Метрологія для новітніх вузлів: 3 нм і далі
Оскільки виробництво напівпровідників просувається до 3 нм вузла й далі, метрологія стикається з безпрецедентними викликами в точності, роздільній здатності та продуктивності. На цих просунутих вузлах критичні розміри (КР) зменшуються до атомного масштабу, а вікна процесу звужуються, що робить традиційні метрологічні техніки недостатніми. Складність архітектури пристроїв – такі як транзистори з повним обертом (GAA) та 3D NAND – вимагає метрологічних рішень, здатних характеризувати структури з високим аспектним співвідношенням, поховані елементи та нові матеріали з субнанометровою точністю.
Оптична метрологія, включаючи розсіювання та еліпсометрію, залишається основною для неруйнівних, високопродуктивних вимірювань, але її ефективність зменшується, коли розміри елементів наближаються до довжини хвилі світла. В результаті гібридні методи, які поєднують оптичні методи з високороздільними техніками, такими як скануюча електронна мікроскопія критичних розмірів (CD-SEM) та передавальна електронна мікроскопія (TEM), все частіше приймаються. Ці методи надають доповнюючу інформацію, що дозволяє більш точно контролювати процеси та виявляти дефекти на атомному рівні ASML.
Машинне навчання та розширена аналітика також інтегруються в метрологічні робочі процеси для інтерпретації складних, високо-розмірних даних та прогнозування варіацій процесу в режимі реального часу. Внутрішня метрологія, яка дозволяє отримувати негайну інформацію та коригування процесів, є критично важливою для підвищення виходу на цих вузлах KLA Corporation. Крім того, галузь інвестує в нові метрологічні платформи, такі як рентгенівські техніки та атомна пробна томографія, щоб вирішити обмеження традиційних інструментів і дозволити характеристику все менших елементів і нових матеріалів Lam Research.
ШІ та автоматизація в метрології напівпровідників
Інтеграція штучного інтелекту (ШІ) та автоматизації швидко трансформує метрологію напівпровідників, забезпечуючи безпрецедентні рівні точності, швидкості та ефективності в контролі процесу. Традиційні метрологічні методи, хоча й дуже точні, часто не встигають за зменшенням геометрії та зростанням складності сучасних пристроїв напівпровідникової техніки. Рішення на основі ШІ вирішують ці проблеми, використовуючи алгоритми машинного навчання для аналізу величезних наборів даних, що генеруються під час інспекції ваферів та вимірювань, виявляючи тонкі патерни та аномалії, які можуть бути непоміченими традиційними техніками.
Автоматизовані метрологічні системи, що підтримуються ШІ, можуть адаптивно оптимізувати рецепти вимірювання, зменшувати людське втручання та мінімізувати невизначеність вимірювань. Наприклад, алгоритми ШІ можуть прогнозувати відхилення процесу та відхилення інструментів у режимі реального часу, що дозволяє проводити проактивні коригування, що підтримують вихід і продуктивність пристроїв. Більше того, використання глибокого навчання у класифікації дефектів прискорює аналіз корінних причин, що дозволяє створювати швидші зворотні зв’язки між метрологією та виробничим обладнанням. Ця синергія є критично важливою для новітніх вузлів, таких як 5 нм і менше, де допуски надзвичайно жорсткі, а вікна процесу звужені.
Основні гравці галузі активно інвестують у платформи метрології на основі ШІ. Такі компанії, як KLA Corporation і Applied Materials, представили рішення, які поєднують високопродуктивне обладнання з розширеною аналітикою, підтримуючи як внутрішній, так і кінцевий контроль процесів. Коли галузь рухається до «розумного» виробництва та Індустрії 4.0, роль ШІ та автоматизації в метрології напівпровідників, ймовірно, буде зростати, сприяючи подальшому поліпшенню виходу, витрат та часу виходу на ринок.
Тенденції ринку та провідні учасники галузі
Ринок метрології напівпровідників зазнає сталого зростання, зумовленого збільшенням складності напівпровідникових пристроїв і переходом на просунуті технологічні вузли, такі як 5 нм і менше. Оскільки геометрії пристроїв зменшуються і 3D-архітектури, такі як FinFET та транзистори з повним обертом (GAA), стають основними, попит на точні, високопродуктивні метрологічні рішення посилився. Ключові тенденції включають інтеграцію штучного інтелекту та машинного навчання для аналізу даних, прийняття внутрішніх та реальних метрологічних систем, а також розробку неруйнівних, високороздільних вимірювальних технік для підтримки просунутих виробничих процесів.
Провідні гравці галузі активно інвестують у НДДКР для вирішення цих еволюційних вимог. KLA Corporation залишається домінуючою силою, пропонуючи комплексне портфоліо інструментів інспекції та метрології для передніх і задніх процесів виробництва напівпровідників. ASML Holding, відомий перш за все своїми літографічними системами, розширив свої можливості метрології, особливо в контексті екстремальної ультрафіолетової (EUV) літографії. Hitachi High-Tech Corporation та Thermo Fisher Scientific також займають провідні позиції, надаючи розширені рішення електронної мікроскопії та спектроскопії для аналізу критичних розмірів і дефектів. Крім того, Onto Innovation та Camtek Ltd. визнані за свої спеціалізовані системи метрології та інспекції, адаптовані до просунутої упаковки та гетерогенної інтеграції.
Конкуренція посилюється також за рахунок стратегічних партнерств, злиттів та поглинань, оскільки компанії намагаються розширити свої технологічні можливості та глобальну присутність. Оскільки напівпровідникова індустрія продовжує розширювати межі мініатюризації та продуктивності, сектор метрології готовий до сталих інновацій та розширення.
Перспективи: масштабування, інтеграція та нові матеріали
Майбутнє метрології напівпровідників формується невпинним прагненням до масштабування пристроїв, гетерогенної інтеграції та впровадження нових матеріалів. Оскільки галузь наближається до ері ангстремів, традиційні методи метрології стикаються зі значними викликами у вирішенні все менших елементів, тривимірних структур і складних стеків матеріалів. Новітні вузли, такі як ті, що на рівні 2 нм і нижче, вимагають метрологічних рішень із субнанометровою точністю та можливістю характеристики похованих інтерфейсів і дефектів без ушкодження зразка. Це спровокувало розвиток гібридних метрологічних підходів, що поєднують методи, такі як атомно-силова мікроскопія (АСМ), передавальна електронна мікроскопія (TEM) та рентгенівські методи, щоб забезпечити комплексні, високороздільні дані Ассоціація напівпровідникової промисловості.
Інтеграція нових матеріалів – таких як матеріали каналу з високою рухливістю (наприклад, германій, III-V сполуки), 2D матеріали (графен, дихалькогенід перехідних металів) і розширені діелектрики – вводить додаткову складність. Ці матеріали часто демонструють унікальні властивості та інтерфейси, які важко охарактеризувати за допомогою традиційних інструментів. Метрологія повинна розвиватися, щоб надавати хімічну, структурну та електричну інформацію на атомному рівні, сприяючи інноваціям у спектроскопічній еліпсометрії, атомній пробній томографії та внутрішній електронній мікроскопії Національний інститут стандартів і технологій.
Дивлячись у майбутнє, інтеграція штучного інтелекту та машинного навчання в метрологічні робочі процеси обіцяє прискорити аналіз даних, дозволити прогностичний контроль процесу та сприяти ухваленню рішень у реальному часі при виробництві. Оскільки архітектури пристроїв та матеріали продовжують диверсифікуватися, сектор метрології залишиться критично важливим для інновацій у сфері напівпровідників, забезпечуючи вихід, надійність та продуктивність у технологіях наступного покоління Applied Materials.
Джерела та посилання
- Національний інститут стандартів і технологій (NIST)
- ASML
- Ассоціація напівпровідникової промисловості
- KLA Corporation
- Hitachi High-Tech Corporation
- Thermo Fisher Scientific
- Onto Innovation
- Camtek Ltd.






